近期,台积电在北美技术论坛上分享了其最新的N2(2纳米制程)工艺在缺陷率控制方面的表现,这一消息引起了广泛关注。与之前推出的7纳米、5纳米及3纳米制程相比,N2工艺在缺陷率上展现出了更为出色的控制能力。
尽管台积电并未透露具体的缺陷率数据,但会上展示了各制程工艺在不同时间段的缺陷率变化趋势。值得注意的是,N2工艺是台积电首次采用GAAFET全环绕晶体管技术的工艺节点,距离其大规模量产预计还有两个季度的时间,预计年底能够正式投产。
从试产阶段的数据来看,N2工艺的缺陷率与同期的N5(5纳米)/N4(4纳米)工艺相当,甚至在某些方面略胜一筹,明显优于N7(7纳米)/N6以及N3/N3P(3纳米)工艺。在过去的近两个月里,N2工艺的表现尤为亮眼。回顾历史数据,N7/N6工艺在试产到量产的半年内,综合缺陷率一直相对较高,而N3/N3P工艺自量产以来便维持在一个较低的水平。相比之下,N5/N4工艺从试产初期就展现出了极低的缺陷率。
台积电方面表示,如果N2工艺能够继续沿着N5/N4的改善路径发展,其未来的市场前景将极为广阔。同时,台积电还强调了工艺缺陷率下降速度的重要性,这不仅与工艺设计和技术本身有关,还与芯片的生产数量和产能规模密切相关。大规模的生产能够更快地发现潜在问题,从而及时进行改进。
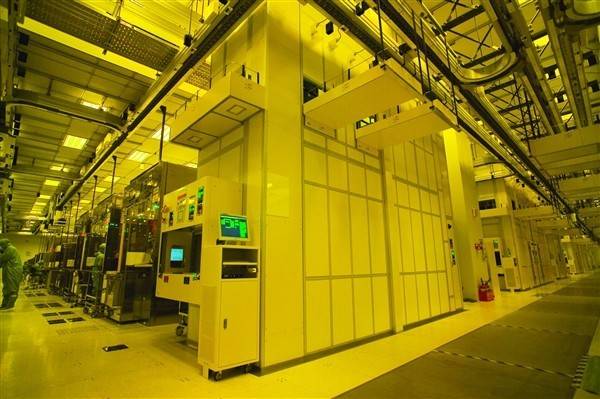
目前,N2工艺已经完成了大量芯片的流片工作,这是其能够快速降低缺陷率的关键因素之一。随着生产数量的不断增加,台积电有信心进一步优化N2工艺,确保其能够顺利实现大规模量产。





